商机详情 -
四川SEMIKRON西门康IGBT模块推荐货源
一个空穴电流(双极)。当UCE大于开启电压UCE(th),MOSFET内形成沟道,为晶体管提供基极电流,IGBT导通。2)导通压降电导调制效应使电阻RN减小,通态压降小。所谓通态压降,是指IGBT进入导通状态的管压降UDS,这个电压随UCS上升而下降。3)关断当在栅极施加一个负偏压或栅压低于门限值时,沟道被禁止,没有空穴注入N-区内。在任何情况下,如果MOSFET的电流在开关阶段迅速下降,集电极电流则逐渐降低,这是阂为换向开始后,在N层内还存在少数的载流子(少于)。这种残余电流值(尾流)的降低,完全取决于关断时电荷的密度,而密度又与几种因素有关,如掺杂质的数量和拓扑,层次厚度和温度。少子的衰减使集电极电流具有特征尾流波形。集电极电流将引起功耗升高、交叉导通问题,特别是在使用续流二极管的设备上,问题更加明显。鉴于尾流与少子的重组有关,尾流的电流值应与芯片的Tc、IC:和uCE密切相关,并且与空穴移动性有密切的关系。因此,根据所达到的温度,降低这种作用在终端设备设计上的电流的不理想效应是可行的。当栅极和发射极间施加反压或不加信号时,MOSFET内的沟道消失,晶体管的基极电流被切断,IGBT关断。4)反向阻断当集电极被施加一个反向电压时,J。 MOSFET驱动功率很小,开关速度快,但导通压降大,载流密度小。四川SEMIKRON西门康IGBT模块推荐货源
SEMIKRON西门康IGBT模块
因为高速开断和关断会产生很高的尖峰电压,及有可能造成IGBT自身或其他元件击穿。(3)IGBT开通后,驱动电路应提供足够的电压、电流幅值,使IGBT在正常工作及过载情况下不致退出饱和而损坏。(4)IGBT驱动电路中的电阻RG对工作性能有较大的影响,RG较大,有利于抑制IGBT的电流上升率及电压上升率,但会增加IGBT的开关时间和开关损耗;RG较小,会引起电流上升率增大,使IGBT误导通或损坏。RG的具体数据与驱动电路的结构及IGBT的容量有关,一般在几欧~几十欧,小容量的IGBT其RG值较大。(5)驱动电路应具有较强的抗干扰能力及对IG2BT的保护功能。IGBT的控制、驱动及保护电路等应与其高速开关特性相匹配,另外,在未采取适当的防静电措施情况下,G—E断不能开路。四、IGBT的结构IGBT是一个三端器件,它拥有栅极G、集电极c和发射极E。IGBT的结构、简化等效电路和电气图形符号如图所示。如图所示为N沟道VDMOSFFT与GTR组合的N沟道IGBT(N-IGBT)的内部结构断面示意图。IGBT比VDMOSFET多一层P+注入区,形成丁一个大面积的PN结J1。由于IGBT导通时由P+注入区向N基区发射少子,因而对漂移区电导率进行调制,可仗IGBT具有很强的通流能力。介于P+注入区与N-漂移区之间的N+层称为缓冲区。 山东哪里有SEMIKRON西门康IGBT模块哪里有卖的在IGBT导通后的大部分漏极电流范围内,Id与Ugs呈线性关系。
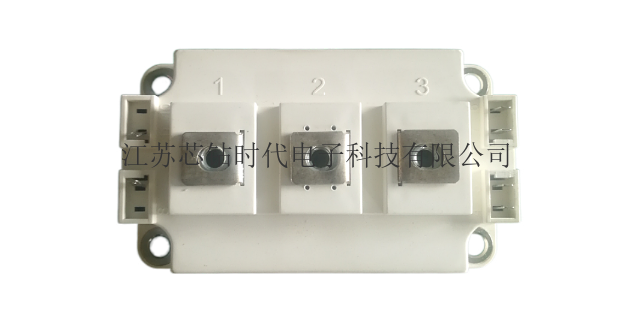
分两种情况:②若栅-射极电压UGE<Uth,沟道不能形成,IGBT呈正向阻断状态。②若栅-射极电压UGE>Uth,栅极沟道形成,IGBT呈导通状态(正常工作)。此时,空穴从P+区注入到N基区进行电导调制,减少N基区电阻RN的值,使IGBT通态压降降低。IGBT各世代的技术差异回顾功率器件过去几十年的发展,1950-60年代双极型器件SCR,GTR,GTO,该时段的产品通态电阻很小;电流控制,控制电路复杂且功耗大;1970年代单极型器件VD-MOSFET。但随着终端应用的需求,需要一种新功率器件能同时满足:驱动电路简单,以降低成本与开关功耗、通态压降较低,以减小器件自身的功耗。1980年代初,试图把MOS与BJT技术集成起来的研究,导致了IGBT的发明。1985年前后美国GE成功试制工业样品(可惜后来放弃)。自此以后,IGBT主要经历了6代技术及工艺改进。从结构上讲,IGBT主要有三个发展方向:1)IGBT纵向结构:非透明集电区NPT型、带缓冲层的PT型、透明集电区NPT型和FS电场截止型;2)IGBT栅极结构:平面栅机构、Trench沟槽型结构;3)硅片加工工艺:外延生长技术、区熔硅单晶;其发展趋势是:①降低损耗②降低生产成本总功耗=通态损耗(与饱和电压VCEsat有关)+开关损耗(EoffEon)。
所有人都知道IGBT的标准定义,但是很少有人详细地、系统地从这句话抽丝剥茧,一层一层地分析为什么定义里说IGBT是由BJT和MOS组成的,它们之间有什么区别和联系,在应用的时候,什么时候能选择IGBT、什么时候选择BJT、什么时候又选择MOSFET管。这些问题其实并非很难,你跟着我看下去,就能窥见其区别及联系。为什么说IGBT是由BJT和MOSFET组成的器件?要搞清楚IGBT、BJT、MOSFET之间的关系,就必须对这三者的内部结构和工作原理有大致的了解。BJT:双极性晶体管,俗称三极管。内部结构(以PNP型BJT为例)如下图所示。BJT内部结构及符号如同我上篇文章(IGBT这玩意儿——从名称入手)讲的,双极性即意味着器件内部有空穴和电子两种载流子参与导电,BJT既然叫双极性晶体管,那其内部也必然有空穴和载流子,理解这两种载流子的运动是理解BJT工作原理的关键。由于图中e(发射极)的P区空穴浓度要大于b(基极)的N区空穴浓度,因此会发生空穴的扩散,即空穴从P区扩散至N区。同理,e(发射极)的P区电子浓度要小于b(基极)的N区电子浓度,所以电子也会发生从N区到P区的扩散运动。这种运动终会造成在发射结上出现一个从N区指向P区的电场,即内建电场。 IGBT的伏安特性是指以栅源电压Ugs为参变量时,漏极电流与栅极电压之间的关系曲线。

有无缓冲区决定了IGBT具有不同特性。有N*缓冲区的IGBT称为非对称型IGBT,也称穿通型IGBT。它具有正向压降小、犬断时间短、关断时尾部电流小等优点,但其反向阻断能力相对较弱。无N-缓冲区的IGBT称为对称型IGBT,也称非穿通型IGBT。它具有较强的正反向阻断能力,但它的其他特性却不及非对称型IGBT。如图2-42(b)所示的简化等效电路表明,IGBT是由GTR与MOSFET组成的达林顿结构,该结构中的部分是MOSFET驱动,另一部分是厚基区PNP型晶体管。五、IBGT的工作原理简单来说,IGBT相当于一个由MOSFET驱动的厚基区PNP型晶体管,它的简化等效电路如图2-42(b)所示,图中的RN为PNP晶体管基区内的调制电阻。从该等效电路可以清楚地看出,IGBT是用晶体管和MOSFET组成的达林顿结构的复合器件。冈为图中的晶体管为PNP型晶体管,MOSFET为N沟道场效应晶体管,所以这种结构的IGBT称为N沟道IIGBT,其符号为N-IGBT。类似地还有P沟道IGBT,即P-IGBT。IGBT的电气图形符号如图2-42(c)所示。IGBT是—种场控器件,它的开通和关断由栅极和发射极间电压UGE决定,当栅射电压UCE为正且大于开启电压UCE(th)时,MOSFET内形成沟道并为PNP型晶体管提供基极电流进而使IGBT导通,此时,从P+区注入N-的空穴。 IGBT在关断过程中,漏极电流的波形变为两段。陕西进口SEMIKRON西门康IGBT模块代理商
减小N-层的电阻,使IGBT在高电压时,也具有低的通态电压。四川SEMIKRON西门康IGBT模块推荐货源
对于本领域普通技术人员来讲,在不付出创造性劳动的前提下,还可以根据这些附图获得其他的附图。图1为本发明实施例提供的一种igbt器件的结构图;图2为本发明实施例提供的一种电流敏感器件的结构图;图3为本发明实施例提供的一种kelvin连接示意图;图4为本发明实施例提供的一种检测电流与工作电流的曲线图;图5为本发明实施例提供的一种igbt芯片的结构示意图;图6为本发明实施例提供的另一种igbt芯片的结构示意图;图7为本发明实施例提供的一种igbt芯片的表面结构示意图;图8为本发明实施例提供的另一种igbt芯片的表面结构示意图;图9为本发明实施例提供的另一种igbt芯片的表面结构示意图;图10为本发明实施例提供的另一种igbt芯片的表面结构示意图;图11为本发明实施例提供的另一种igbt芯片的表面结构示意图;图12为本发明实施例提供的另一种igbt芯片的表面结构示意图;图13为本发明实施例提供的另一种igbt芯片的表面结构示意图;图14为本发明实施例提供的另一种igbt芯片的表面结构示意图;图15为本发明实施例提供的一种半导体功率模块的结构示意图;图16为本发明实施例提供的一种半导体功率模块的连接示意图。图标:1-电流传感器;10-工作区域;101-第1发射极单元。 四川SEMIKRON西门康IGBT模块推荐货源